随着信息技术的快速发展,全球数据量以惊人的速度持续增长,对非易失性存储器提出了大容量、高速、低功耗的迫切需求。随着器件特征尺寸缩微日益困难,多值存储技术,是指在单个存储单元中实现多比特的存储态,已成为大幅提升存储容量的重要方向。氧化铪(HfO2)基铁电薄膜凭借其优异的CMOS工艺兼容性、高速读写特性和低功耗优势,特别是其独特的晶胞内隔离带-极化带结构可实现亚纳米尺度偶极子独立翻转的特征,有望推动铁电存储器成为下一代存储技术。
印记效应是铁电存储器主要的可靠性问题之一,宏观表现为特性极化状态保持之后的电滞回线沿电压轴产生偏移,易导致数据写入错误。值得指出的是,相对于钙钛矿结构铁电电容,HfO2基铁电电容表现出更显著的印记效应。例如,使某一极化状态在85℃下保持数分钟后,其电滞回线偏移量达到1.5 MV/cm,与其矫顽电场值相当。在HfO2基铁电多值存储中,相邻状态间的裕度(可区分各存储态的允许误差)减小,且中间极化态的电畴演变及其与缺陷的耦合机制更为复杂。目前,HfO2基铁电多值存储的印记行为与物理机制尚未被揭示。
近日,H动漫
周益春教授团队在这一研究领域取得重要进展。研究团队在多值HfAlOx铁电电容中发现尽管饱和极化状态受到印记影响后仍能被准确写入,但所有中间极化状态的写入却完全发生错误。针对这一发现,团队重点分析了印记效应产生前后铁电电容内建电场和带电缺陷(主要是带电氧空位)的变化及其关联,提出了多值存储极化状态影响带电氧空位分布并形成非均匀内建电场、进而导致中间极化状态无法被准确写入的失效模型。该模型通过相场模拟得到了进一步验证。在此基础上,团队设计了一种预编程方法,通过使铁电薄膜的内氧空位重新分布来抵消印记效应的影响。实验证明该策略能在室温环境下实现长期稳定的准确编程,为发展可靠的多值HfO2基铁电存储器提供了新的途径。该研究成果以“The Imprint Failure and Suppression of the Multi-Level Memory in HfAlOxFerroelectric Capacitor”为题发表在材料领域著名学术期刊Advanced Functional Materials上(2024年影响因子为18.5)。论文的第一单位为H动漫
,材料院博士生包克瑜为论文第一作者,
 论文封面
论文封面
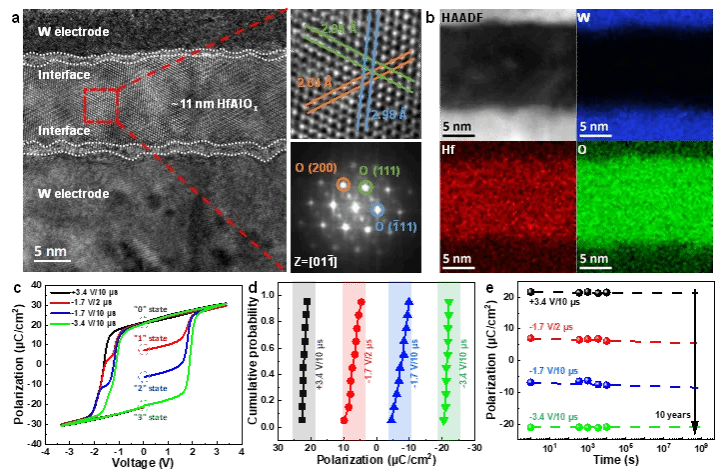
团队设计制备的能长时间保存数据、实现2-bit/cell多值存储HfAlOx电容。
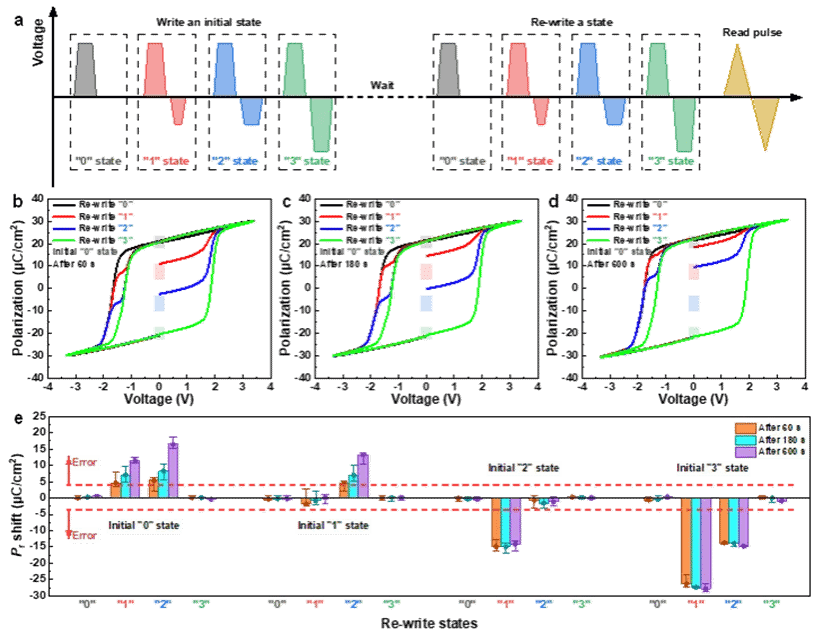
在写入操作中饱和极化状态写入准确,中间极化状态受印记效应影响容易出错。
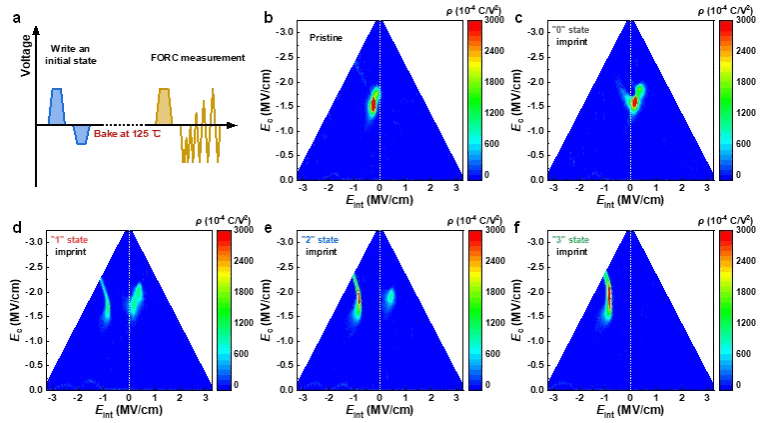
HfAlOx电容在不同多值存储状态下产生印记效应后出现的复杂内建电场。
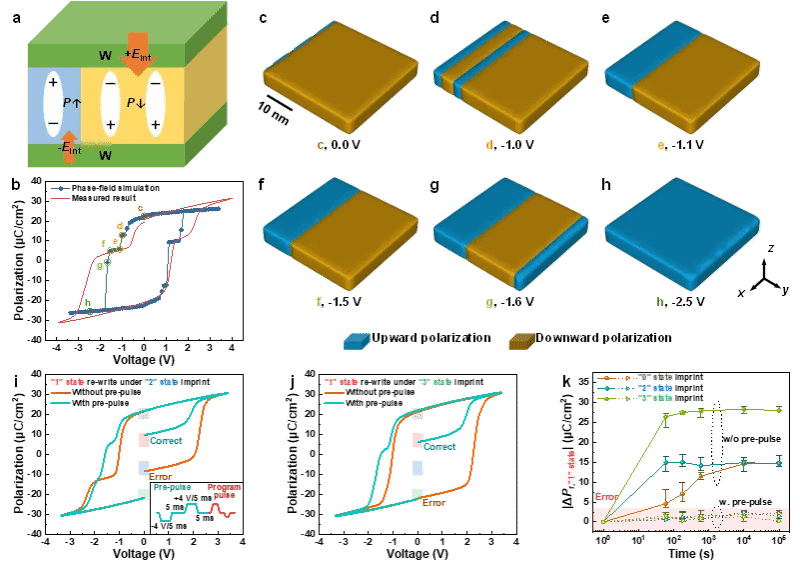
经相场模拟验证的多值铁电HfO2印记失效模型;以及实现室温长期稳定写入的预编程方法。
论文链接://doi.org/10.1002/adfm.202509227